在SMT贴片加工过程中,焊接质量直接关系到电子产品的性能和可靠性。本文将针对SMT贴片加工中常见的焊接缺陷进行系统分析,并提供实用的解决方案,帮助您提升生产质量。
桥接:引脚间的短路隐患
桥接是SMT加工中尤为常见的缺陷,表现为相邻引脚或焊盘之间被多余的焊料连接,导致电气短路。
产生原因分析:
- 焊膏过量:模板厚度不当或开孔尺寸过大,导致焊膏沉积过多
- 印刷错位:高密度组件印刷时定位不准,使焊膏印到焊盘之外
- 焊膏塌陷:焊膏粘度不足、模板孔壁粗糙或刮刀压力过大,造成印刷后焊膏坍塌
- 贴装压力不当:元件贴装时压力过大,使焊膏变形塌边
解决方案:
- 根据元件引脚间距选择合适的模板厚度,通常采用0.15mm厚度模板
- 对于引脚间距小于0.65mm的印制板,采用光学定位技术
- 选择粘度较高的焊膏,提高保形性
- 采用激光切割模板,确保孔壁光滑
- 优化贴装压力参数,避免压力过大

立碑现象:小尺寸元件的挑战
立碑现象(又称"曼哈顿现象")是CHIP元件回流焊接中特有的缺陷,表现为元件一端翘起,如同墓碑。
产生原因分析:
- 预热不当:预热温度过低或时间过短,使元件两端焊膏不同时熔化
- 焊盘设计不对称:焊盘尺寸或形状不一致,导致表面张力不平衡
- 贴装偏移:元件贴装位置偏差过大,超出焊膏熔融时的自校正能力
- 元件重量过轻:小尺寸元件更易被不平衡的张力拉动
解决方案:
- 优化预热工艺参数,预热温度一般设置在150±10℃,时间60-90秒
- 保持焊盘设计的对称性,形状与尺寸完全一致
- 提高贴装精度,避免过大偏差
- 在满足产品需求前提下,优先选择尺寸重量较大的元件
- 减小焊膏厚度,使用0.15mm以下模板
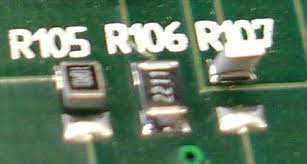
冷焊:强度不足的隐患
冷焊表现为焊点表面暗淡、凹凸不平,呈颗粒状,严重影响焊接强度。
产生原因分析:
- 加热不足:回流焊温度不足或时间过短,焊料未完全熔化
- 热容量不均:大尺寸焊盘或接地层设计不合理,导致热量散失过快
- 传送带振动:回流焊过程中机械振动影响焊料正常熔融
解决方案:
- 确保回流焊机具有精确的温度控制,根据焊膏和元件要求设定适当参数
- 优化PCB设计,对于连接到大面积铜箔的焊盘,采取热隔离设计
- 检查回流炉传送系统,减少机械振动
- 设置适当的回流焊接温度曲线,确保焊料完全熔化
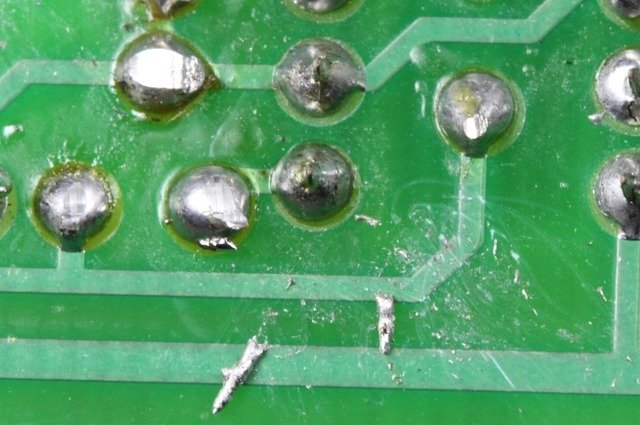
焊锡球:潜在的短路风险
焊锡球表现为PCB非焊接区域出现分散的焊料小球,可能引起电路短路。
产生原因分析:
- 焊膏氧化:焊膏暴露空气中时间过长,氧化物含量增加
- 加热速率过快:快速升温使焊膏中溶剂剧烈挥发,溅出焊料颗粒
- 焊膏吸湿:从冰箱取出后未充分回温,水分凝结
- 模板开孔不当:开孔尺寸与焊盘不匹配
- 助焊剂活性不足:特别是免洗焊膏活性相对较低
解决方案:
- 控制焊膏氧化物含量,一般不超过0.15%
- 调整回流曲线,使焊膏在焊接前充分预热
- 焊膏从冰箱取出后,应在室温下回温再开盖使用
- 模板开孔尺寸比相对应焊盘小10%
- 加强印制板清洗,确保印错后彻底清洗
虚焊与润湿不良:连接不可靠的根源
虚焊表现为焊盘未完全润湿,元件与电路板之间未能形成牢固连接。
产生原因分析:
- 表面污染:焊盘或元件引脚存在氧化或污染
- 助焊剂活性不足:未能有效去除金属表面氧化物
- 加热不足:焊盘和引脚未均匀加热到适当温度
解决方案:
- 确保焊接前PCB板和元件清洁,无氧化和污染
- 选择活性适当的助焊剂
- 保证足够的预热时间和温度,使焊盘和引脚均匀受热
针孔与气孔:隐藏的内部缺陷
针孔与气孔是焊点内部的气体残留造成的空隙,影响焊接的机械强度和导电性能。
产生原因分析:
- PCB吸湿:板内水分受热变成蒸汽,在焊料凝固前未完全逸出
- 镀铜厚度不足:通孔镀铜层过薄,不能阻止水分渗透
- 焊膏残留气体:助焊剂未充分蒸发,残留气体形成空洞
解决方案:
- 焊接前对PCB板进行预烘烤,去除水分
- 确保通孔处有至少25μm的最小镀铜厚度
- 正确设定回流焊温度曲线,使助焊剂充分蒸发
焊盘剥离:PCB的致命损伤
焊盘剥离是焊接时间过长或反复焊接导致焊盘从PCB上脱离,造成永久性损坏。
产生原因分析:
- 过热焊接:焊接时间过长或温度过高
- 机械应力过大:焊盘位置受到不当外力
- 反复焊接:同一焊点多次返修
解决方案:
- 控制焊接时间和温度,避免过热
- 维修时使用适当的工具和技术
- 对于已剥离的焊盘,可采用飞线或搭桥方式修复
SMT焊接缺陷的系统化预防策略
要有效减少SMT焊接缺陷,需要建立系统化的预防策略:
优化工艺参数:
- 根据不同的产品特点和元器件,精心设置回流焊温度曲线
- 控制贴装精度和压力参数
- 优化印刷参数,包括刮刀角度、压力和速度
加强物料管理:
- 严格管理焊膏的存储和使用,确保在有效期内使用
- 控制车间环境温湿度
- 确认元器件和PCB的可焊性
完善质量控制:
- 实施SPC统计过程控制,及时发现工艺偏差
- 建立完善的质量追溯系统
- 采用AOI、X-Ray等检测设备监控焊点质量
结语
SMT贴片加工中的焊接缺陷是由多种因素共同影响的结果。通过深入了解各种缺陷的产生机理,采取针对性的预防措施,建立系统化的工艺控制体系,可以显著提高焊接质量和产品良率。 作为专业的SMT贴片加工厂,1943科技拥有完善的质量管理体系和丰富的工艺经验,能够为客户提供高质量的PCBA加工服务。我们持续优化生产工艺,致力于为客户提供"零缺陷"的产品体验。








 2024-04-26
2024-04-26

